近日,英特尔前任首席执行官帕特·基辛格宣布加入了一家名为xLight的初创公司,担任执行董事长一职。这一消息不仅得到了基辛格本人在LinkedIn上的确认,xLight官网也早在上个月就对外公布了这一重要人事变动。
xLight公司专注于极紫外(EUV)光刻机的研发,特别是基于直线电子加速器的自由电子激光(FEL)技术的EUV光源系统。该公司声称,其技术能够将系统及运营成本降低三倍,并计划在2028年实现商用,同时保持与现有设备的兼容性。

xLight的粒子加速器技术是其核心竞争力的关键所在。帕特·基辛格对此表示:“我们正站在自互联网诞生以来计算基础设施最具变革性的时刻。我期待着与xLight合作,推动下一代半导体制造。自由电子激光器是光刻技术的未来,而xLight无疑是粒子加速器技术领域的领导者。”
xLight的首席执行官Nicholas Kelez对基辛格的加入表示热烈欢迎:“帕特·基辛格对半导体行业的技术理解和知识非常出色,他立即明白了xLight的系统对美国半导体制造业的未来有多么重要。我们很高兴他加入我们的董事会,并期待我们的合作。”
目前,光刻机巨头ASML所采用的EUV光源系统是基于激光等离子体EUV光源(LPP)的。这种技术通过高功率的二氧化碳激光器轰击微小的锡滴,产生13.5nm波长的EUV光线。然而,LPP系统不仅庞大复杂,功耗巨大,而且产生的EUV光源功率有限,导致EUV光刻机成本高昂。全球仅有少数头部晶圆制造厂商能够使用这种单价高达约1.5亿美元的EUV光刻机。
为了降低EUV光源系统的成本,美国、中国、日本等国家的研究机构都在研发基于直线电子加速器的自由电子激光(FEL)技术的EUV光源系统。其中,基于自由电子激光器(FEL)技术的EUV光源方案被寄予厚望。这种技术主要分为振荡器FEL和自放大自发辐射(SASE)FEL两种类型。而SASE-FEL因其适用于短波长FEL,如EUV-FEL,成为目前研究的主要方向。
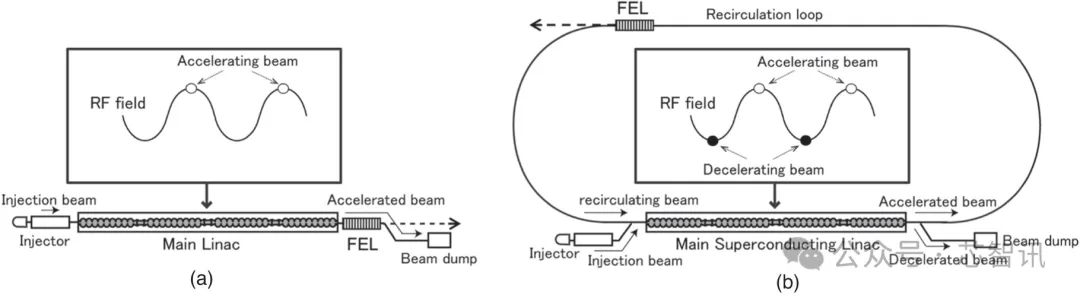
与LPP光源相比,基于能量回收直线加速器(ERL)的EUV-FEL光源具有多项优势。它可以产生超过10kW的高EUV功率,且不会产生锡滴碎片,因此可以同时为多台EUV光刻机提供高功率的EUV光源,而不会对反射镜面造成锡污染。EUV-FEL光源的建设和运营成本也远低于LPP光源。
xLight公司正是基于ERL的EUV-FEL技术路线研发EUV光源系统的。根据官网资料显示,xLight由一支由光源先驱、光刻师和粒子加速器制造商组成的团队领导。其首席科学家Gennady Stupakov博士还是2024年IEEE核能和等离子体科学学会粒子加速器科学技术奖(PAST奖)的获奖者之一。
帕特·基辛格在加入xLight后表示,xLight研发的EUV光源系统功率达到了当今最先进EUV光源系统的四倍,即1000W左右,并计划在2028年准备好用于商业化应用。这将为制造效率带来重大飞跃,大幅降低每片晶圆的光刻成本,并减少资本和运营支出。
xLight的目标并不是取代ASML的EUV光刻工具,而是推出一个可以兼容ASML EUV光刻机的EUV-FEL光源系统。虽然目前尚不清楚xLight的EUV光源系统是否会兼容ASML的High NA EUV系统,但据现有信息来看,ASML的High NA EUV光刻机依然是基于EUV-LPP技术路径,因此有望实现兼容。
xLight成立的使命是打造一种能够彻底改变光刻、计量和检测的光源。该公司利用美国在粒子加速器技术、基础设施和知识方面的领导地位,正在快速开发和部署其独特的EUV-FEL光源解决方案,以实现更经济、更可持续的EUV光刻未来。在此基础上,xLight设计了一个具有新功能的HVM(大批量制造)兼容系统,该系统可提供生产力和性能,从而推动尖端半导体制造业的持续进步。





















